Garantiamo il supporto a lungo termine dei componenti per i footprint SOIC esistenti e per i PLCC con numero di pin ridotto.
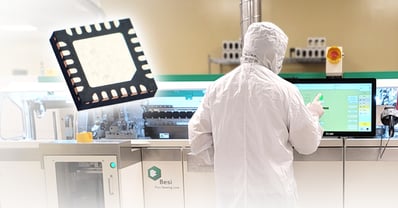 Nella prima parte della nostra panoramica sulla produzione abbiamo esaminato la storia di come e perché gli assemblaggi di semiconduttori si sono allontanati dal classico assemblaggio di lead frame. Per ricapitolare, questi richiedono costosi strumenti di taglio e lavorazione, come PDIP, PLCC, PQUAD e PGA, e il mercato si è spostato verso i substrati BGA (Ball Grid Array), QFN (Quad Flat No-lead Package) e DFN (Dual Flat No-lead Package). In questo caso, ci concentriamo sugli assemblaggi QFN e DFN, che rientrano nella fascia bassa di complessità e costo, ma che avranno un forte impatto sul futuro degli assemblaggi SOIC e PLCC a basso numero di pin.
Nella prima parte della nostra panoramica sulla produzione abbiamo esaminato la storia di come e perché gli assemblaggi di semiconduttori si sono allontanati dal classico assemblaggio di lead frame. Per ricapitolare, questi richiedono costosi strumenti di taglio e lavorazione, come PDIP, PLCC, PQUAD e PGA, e il mercato si è spostato verso i substrati BGA (Ball Grid Array), QFN (Quad Flat No-lead Package) e DFN (Dual Flat No-lead Package). In questo caso, ci concentriamo sugli assemblaggi QFN e DFN, che rientrano nella fascia bassa di complessità e costo, ma che avranno un forte impatto sul futuro degli assemblaggi SOIC e PLCC a basso numero di pin.
Perché il settore si è orientato verso assemblaggi QFN e DFN con un numero inferiore di pin e quale sarà l'impatto sull'obsolescenza dei componenti?
In precedenza abbiamo analizzato il motivo per cui le classiche tecnologie di lead frame vengono eliminate e come il costo maggiore in questo tipo di assemblaggio sia dovuto agli strumenti di taglio e formatura. Per riassumere, nel 2000 i margini di profitto per gli assemblaggi di lead frame classici a più alto volume sono calati al di sotto del 10%, in quanto sono diventati una specialità supportata da pochi produttori di semiconduttori. Un package PLCC di una sola dimensione può costare oltre 300.000 US$ solo per le attrezzature di taglio e formatura. Tuttavia, questi package raggiunsero un picco di volume negli anni '90, quando i costi di assemblaggio erano significativamente inferiori a volumi più elevati e comprendevano l'attacco, il wire bonding, lo stampo, il taglio e la formatura dei die.
Vediamo nel dettaglio perché il QFN sarà conveniente in futuro. Sebbene gli assemblaggi QFN siano basati su lead frame, non necessitano di utensili per il taglio e la formatura. Il lead frame di un QFN è una matrice XxY, come una tavoletta di cioccolato a quadratini, dove le dimensioni XxY dei singoli QFN sono flessibili. Le dimensioni dello stampo e le dimensioni del lead frame esterno sono le stesse per molte dimensioni dell'assemblaggio finale QFN. Le dimensioni comuni dei singoli gruppi QFN sono 3x3 mm, 4x4 mm, 5x5 mm e molte altre. I lead frame QFN e DFN vengono stampati tutti insieme e poi segati per formare i singoli gruppi QFN. Le dimensioni dei gruppi DFN sono più variegate, ma hanno sempre un numero di pin inferiore rispetto ai QFN. La lavorazione dello stampo può essere la stessa per la maggior parte delle dimensioni sia dei QFN che dei DFN.
Dopo l'operazione di segatura, l'assemblaggio è quasi completo. Il risultato è un assemblaggio QFN/DFN stampato che non richiede costose operazioni di taglio e formatura e che necessita di un solo strumento di stampo per diversi formati QFN/DFN. Il volume di produzione è molto più veloce anche senza le operazioni di taglio e formatura. Senza un'operazione di taglio e formatura, il rendimento di un assemblaggio QFN/DFN è superiore a quello di un package con numero di pin equivalente che necessita di taglio e formatura. Minore ingombro fisico, maggiore volume di produzione e rendimenti più elevati sono il segno dell'obsolescenza definitiva dei classici assemblaggi di lead frame che richiedono operazioni di taglio e formatura.
QFN/DFN porterà alla scomparsa di gruppi lead frame con numero di pin equivalente che necessitano di operazioni di taglio e formatura. Tutto ciò è già successo ai package DIP classici. Sebbene non siano altrettanto costosi per le operazioni di taglio e formatura, i DIP sono in circolazione da oltre 50 anni e la tecnologia di assemblaggio a foro passante non genera più volumi. Si potrebbe obiettare che i DIP sono già stati sostituiti dai package SOIC, ma non è così per le tempistiche di supporto richieste dai sistemi a lungo ciclo di vita.
I package SOIC saranno sostituiti da assemblaggi di tipo QFN e DFN. Abbiamo già avuto modo di constatare sia la carenza di assemblaggi SOIC sia la totale obsolescenza della versione SOIC di un prodotto, pur mantenendo attiva la versione QFN. Se si esamina un comune componente logico attualmente in commercio, si noterà che in genere viene venduto sia in versione QFN che SOIC, offerte insieme. Queste versioni richiedono un diverso layout della scheda, dato che gli assemblaggi QFN sono offerti nelle classiche dimensioni QFN quadrate menzionate in precedenza. Noi di Rochester riteniamo che offrire la flessibilità di mantenere i layout delle schede SOIC esistenti per il segnale, fornendo al contempo un assemblaggio QFN, sia la strada migliore per supportare i sistemi a lungo ciclo di vita.
Quando è necessaria una maggiore affidabilità dei giunti di saldatura con la scheda di circuito, si utilizza la tecnologia "wettable flank". Un tipico QFN ha una saldatura solo sul fondo dei piedini, lasciando il rame esposto sui lati del package. Ciò complica l'ispezione del giunto di saldatura con il package. La tecnologia "wettable flank" consente al produttore di QFN/DFN di saldare sul lato del lead frame esposto. In questo modo si copre in parte o totalmente il rame esposto e si ottiene una maggiore superficie per l'ispezione successiva al montaggio del giunto di saldatura. In genere, la tecnologia "wettable flank" comporta una lavorazione di assemblaggio più complessa e un aumento dei costi di produzione.

Attualmente, Rochester Electronics offre ai clienti footprint QFN compatibili con i footprint esistenti SOIC o PLCC a basso numero di pin. È possibile ottenere questo risultato con una semplice modifica della scheda per l'area del paddle sotto il QFN. La modifica della scheda è necessaria per garantire la compatibilità con i SOIC in ambienti soggetti a urti e vibrazioni. A meno che il paddle del QFN non sia saldato, gli assemblaggi con lead frame tagliati e formati offrono prestazioni migliori in questi ambienti rispetto a un QFN.
Rochester Electronics ha anticipato queste tendenze del mercato e ha investito negli assemblaggi QFN/DFN. Offriamo i classici assemblaggi QFN quadrati oggi in produzione di massa, ma anche la flessibilità che le aziende di sistemi a lungo termine desiderano quando devono migrare da assemblaggi di altro tipo, fornendo anche assemblaggi QFN non quadrati con compatibilità di footprint e piccole modifiche alla scheda. Rochester sta risolvendo un'altra parte del puzzle dell'obsolescenza per i nostri clienti globali.
In qualità di produttore di semiconduttori su licenza, Rochester ha fabbricato oltre 20.000 tipi di dispositivi. Con oltre 12 miliardi di die in stock, Rochester è in grado di produrre più di 70 mila tipi di dispositivi.
Da oltre 40 anni Rochester, in collaborazione con oltre 70 produttori leader di semiconduttori, fornisce ai nostri stimati clienti una fonte continua di semiconduttori di importanza critica.
Rochester offre un'ampia gamma di capacità di assemblaggio interne che garantiscono consegne rapide. Disponiamo di oltre 240 mila metri quadrati dedicati ai servizi di assemblaggio e oltre 100 mila metri quadrati per l'assemblaggio di materie plastiche e la finitura in piombo.
Offriamo un'ampia gamma di opzioni di incapsulamento in plastica, tra cui:
- Apparecchiature automatiche per taglio, attacco die e wire bonding.
- Apparecchiatura completa per stampi automatici e semiautomatici.
- Spazio di produzione flessibile a supporto di una vasta gamma di volumi.
- Le opzioni di lead frame comprendono progettazione/replica, preplaccate, placcate in situ.
Ispezione in linea automatizzata. - Gold ball bond o copper ball bond.
- Attacco die in resina epossidica.
- Soluzioni di assemblaggio personalizzate.
- Servizi di qualificazione disponibili.
Replica di package, substrato e lead frame
- Capacità di reintrodurre la maggior parte delle tecnologie di package.
- Sono disponibili finiture in piombo ROHS/SnPb.
- Package in conformità con le specifiche JEDEC e package personalizzati.
- Sono disponibili servizi di progettazione di substrato e lead frame.
- Servizi di qualificazione disponibili.
LEGGI: La prima parte del puzzle della produzione di semiconduttori
GUARDA: Per saperne di più sulle capacità di assemblaggio plastico di Rochester
Scopri di più sui servizi di assemblaggio di Rochester



